
主营产品:
光学仪器、光学材料、实验仪器、手动工具、焊接工具、焊接材料、仪器仪表、静电设备、静电辅料、工业器材、气动元件、电工电气、测量工具、计量设备、气动工具、电动工具、化工设备、化工辅料、点胶设备、小型设备、储存设备、物流设备、工业安防、**防护、包装材料、切削工具、切削材料、办公设备、办公文 具、工装夹具、测试治具、机械加工。设备等。
- 西南区厂家直销 FUNATEC...
- 厂家直销 MUSASHI武藏 ...
- AITEC艾泰克 Power-...
- 重庆上乘粘度计 TOKISA...
- 西南区厂家直销EIWA熔接机拉...
- 功能齐全 重庆内藤销售 KOB...
- 原装进口 静电测量仪 FMX-...
- 折叠耐久试验机 DLDMLH...
- SEN日森 UV硬化装置 台式...
- HID光源 HL - LGJ ...
- USHIO牛尾 照明设备 一般...
- 新品直销,OPK株式会社,托盘...
- 现货直销 SANEI三荣 BS...
- 现货直销 SANEI三荣 SD...
- 西南地区直销 MOUNTZ蒙士...
- DLDMLH-4U 折叠耐久...
- 折叠耐久试验机 DLDMLH-...
- 现货 DIT东日技研 超声波传...
- 现货 DIT东日技研 静电消除...
- 现货 DIT东日技研 喷嘴式/...
- 重庆内藤供应AITEC艾泰克L...
- AITEC艾泰克 氮置换BOX...
- AITEC艾泰克 晶圆UV照射...
- AITEC艾泰克 闪光灯设定数...
- AITEC艾泰克 LPDCH系...
- AITEC艾泰克 LMS 10...
- AITEC艾泰克 红外线照明 ...
- NDK日本电色 浊度/色度仪...
- 内藤代理 日本MUSASHI...
- 重庆内藤代理TND-4500K...
- 武藏MUSASHI点胶机sup...
- 针形控制阀NCV-17日本武藏...
- 日本HAKKO白光自动焊锡系统...
- 日本FLUORO福乐 小型真空...
- 日本MALCOM马康手持式粘度...
- 日本MUSASHI武藏数码控制...
- 日本MUSASHI武藏高精度...
- 日本MUSASHI武藏中国(重...
- INFLIDGE英富丽超级空气...
- 代理点胶机日本MUSASHI武...
- 内藤供应 日本MUSASHI武...
- 代理现货销售 TND-450...
- 日本FLUORO福乐小型真空泵...
- 日本MUSASHI武藏数码控制...
- 日本probe探头 耐500℃...
- INFLIDGE英富丽超级空气...
- SIGMAKOKI西格玛光机2...
- 针形控制阀NCV-17日本武藏...
产品详情
简单介绍:
在晶圆的研磨、抛光等过程中,可以超高速、高精度、非接触地测量晶圆和树脂的厚度。
销售中心-重庆内藤naitokikai
详情介绍:
特征
- 通过光学方法可以进行非接触式和非破坏性的厚度测量。
- 实现高测量再现性
- 可实时高速监控抛光
- 实现了长 WD(工作距离)并且易于集成到设备中
- 从主机设备使用 LAN 通过 TCP/IP 通信进行控制
- 可以进行多层厚度测量
- 可测量临时晶圆(临时键合晶圆)各层厚度
-


测量项目
- 厚度测量(5层)
用法
- 各种晶圆(硅、其他化合物晶圆)的厚度测量
- 融入各种工艺,如研磨、抛光、粘合等。
- 晶圆以外的厚膜部件厚度测量
集成到半导体工艺中的示例
■ 临时粘合
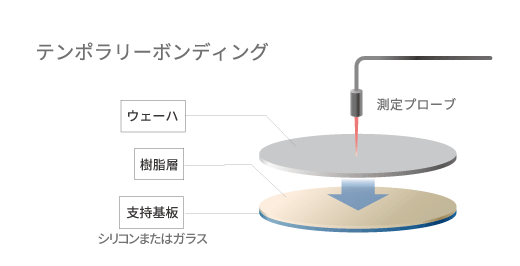

■ 背景研磨
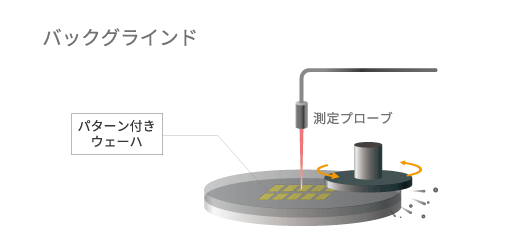

■ 湿蚀刻

■ CMP工艺
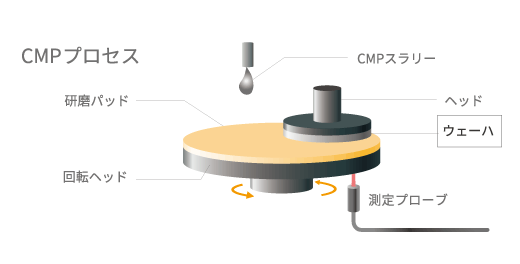
规格

*1 : 测量初始标准样品 AirGap 约 1000 μm 时的相对标准偏差 (n = 20)
*2 : WD80 mm 探头规格的设计值
设备配置

映射
■ 300 毫米晶圆测绘系统
- 通过对准精细图案提供晶圆厚度和各种厚度信息
- 配备高精度XY定位平台(±2μm以下),实现高精度定位
- 可以处理晶圆以外的形状
- 可以检查测量点周围的视野
- 对应半导体用300mm晶圆
- 与 MEMS 和传感器设备兼容
















