
主营产品:
光学仪器、光学材料、实验仪器、手动工具、焊接工具、焊接材料、仪器仪表、静电设备、静电辅料、工业器材、气动元件、电工电气、测量工具、计量设备、气动工具、电动工具、化工设备、化工辅料、点胶设备、小型设备、储存设备、物流设备、工业安防、**防护、包装材料、切削工具、切削材料、办公设备、办公文 具、工装夹具、测试治具、机械加工。设备等。
- 西南区厂家直销 FUNATEC...
- 厂家直销 MUSASHI武藏 ...
- AITEC艾泰克 Power-...
- 重庆上乘粘度计 TOKISA...
- 西南区厂家直销EIWA熔接机拉...
- 功能齐全 重庆内藤销售 KOB...
- 原装进口 静电测量仪 FMX-...
- 折叠耐久试验机 DLDMLH...
- SEN日森 UV硬化装置 台式...
- HID光源 HL - LGJ ...
- USHIO牛尾 照明设备 一般...
- 新品直销,OPK株式会社,托盘...
- 现货直销 SANEI三荣 BS...
- 现货直销 SANEI三荣 SD...
- 西南地区直销 MOUNTZ蒙士...
- DLDMLH-4U 折叠耐久...
- 折叠耐久试验机 DLDMLH-...
- 现货 DIT东日技研 超声波传...
- 现货 DIT东日技研 静电消除...
- 现货 DIT东日技研 喷嘴式/...
- 重庆内藤供应AITEC艾泰克L...
- AITEC艾泰克 氮置换BOX...
- AITEC艾泰克 晶圆UV照射...
- AITEC艾泰克 闪光灯设定数...
- AITEC艾泰克 LPDCH系...
- AITEC艾泰克 LMS 10...
- AITEC艾泰克 红外线照明 ...
- NDK日本电色 浊度/色度仪...
- 内藤代理 日本MUSASHI...
- 重庆内藤代理TND-4500K...
- 武藏MUSASHI点胶机sup...
- 针形控制阀NCV-17日本武藏...
- 日本HAKKO白光自动焊锡系统...
- 日本FLUORO福乐 小型真空...
- 日本MALCOM马康手持式粘度...
- 日本MUSASHI武藏数码控制...
- 日本MUSASHI武藏高精度...
- 日本MUSASHI武藏中国(重...
- INFLIDGE英富丽超级空气...
- 代理点胶机日本MUSASHI武...
- 内藤供应 日本MUSASHI武...
- 代理现货销售 TND-450...
- 日本FLUORO福乐小型真空泵...
- 日本MUSASHI武藏数码控制...
- 日本probe探头 耐500℃...
- INFLIDGE英富丽超级空气...
- SIGMAKOKI西格玛光机2...
- 针形控制阀NCV-17日本武藏...
产品详情
简单介绍:
对应于从薄膜到厚膜的宽膜厚度
功能齐全 重庆内藤销售 FE-300V 薄膜厚度监视器 OTSUKA大塚電子
使用反射光谱的厚度分析
功能齐全 重庆内藤销售 FE-300V 薄膜厚度监视器 OTSUKA大塚電子
结构紧凑·成本低,但非接触式,非破坏性和高度**的测量
简单的条件设置和测量操作!易于测量任何人的膜厚度
详情介绍:
它是一种紧凑,低成本的薄膜厚度计,可以通过高精度的光学干涉方法实现薄膜厚度测量,操作简单。
我们采用了一体化的房屋,在主体中容纳了必要的设备,实现了稳定的数据采集。
光学常数的分析也可以通过获得**反射率来实现,尽管它是低成本的。
我们采用了一体化的房屋,在主体中容纳了必要的设备,实现了稳定的数据采集。
光学常数的分析也可以通过获得**反射率来实现,尽管它是低成本的。
(详情请咨询TEL:18375760285 QQ;1280713150 白先生)
特点
- 对应于从薄膜到厚膜的宽膜厚度
- 使用反射光谱的厚度分析
- 结构紧凑·成本低,但非接触式,非破坏性和高度**的测量
- 简单的条件设置和测量操作!易于测量任何人的膜厚度
- 通过非线性*小二乘法,优化方法,PV方法,FFT分析方法等可以进行各种各样的膜厚度测量。
- 通过非线性*小二乘法的膜厚度分析算法可以进行光学常数分析(n:折射率,k:消光数计数)
测量项目
- **反射率测量
- 薄膜厚度分析分析(10层)
- 光学常数分析(n:折射率,k:消光米数)
应用程序使用
-
功能性膜,塑料
的透明导电膜(ITO,银纳米线),相位差膜,偏振膜,AR膜,PET,PEN,TAC,PP ,PC,PE,PVA, 胶,粘合剂,保护膜,硬外套,指纹等 -
半导体
化合物半导体,Si,氧化膜,氮化膜,Resist,SiC,GaAs,GaN,InP,InGaAs,SOI,蓝宝石等 -
表面处理的
DLC涂层,防锈剂,防雾剂等 -
光学材料
过滤器,AR涂层等 -
FPD
LCD(CF,ITO,LC,PI),OLED(有机薄膜,密封剂)等 -
其他
硬盘,磁带,建筑材料等
测量原理
使用大冢电子,光学干涉测量和我们自己的高精度分光光度计可实现非接触,无损,高速和高精度的薄膜厚度测量。光学干涉测量法是通过使用由使用如图1所示的分光光度计的光学系统获得的反射率来获得光学膜厚度的方法。例如,如图1所示,在金属基板上涂布膜的情况下,从目标试样的上方入射的光被膜(R1)的表面反射。而且,透过膜的光在基板(金属)或膜界面(R2)上反射。测量此时由于光程差引起的相移引起的光学干涉现象,并根据所获得的反射光谱和折射率计算膜厚度的方法称为光学干涉方法。有四种分析方法:峰谷方法,频率分析方法,非线性*小二乘法和优化方法。
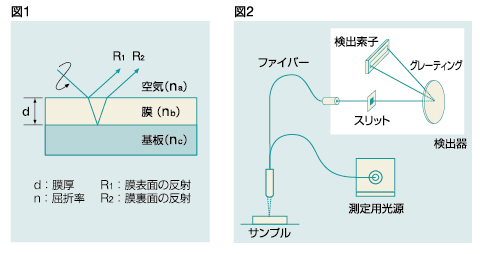
产品规格
| 模型 | FE-300V | FE-300 UV | FE-300 NIR * 1 | |
| 整个 | 标准测量类型 | 薄膜测量类型 | 厚膜测量类型 |
厚膜测量类型 (高分辨率) |
| 样本大小 | *大8英寸晶圆(厚度5毫米) | |||
|
测量的薄膜厚度范围 (nd) |
100纳米到40微米 | 10纳米至20微米 | 3μm至300μm | 15微米到1.5毫米 |
| 测量波长范围 | 450纳米到780纳米 | 300nm至800nm | 900nm至1600nm | 1470nm至1600nm |
| 薄膜厚度精度 | ±0.2 nm * 2以内 | ±0.2 nm * 2以内 | - | - |
| 重复性 | 在0.1纳米* 3以内 | 在0.1纳米* 3以内 | - | - |
| 测量时间 | 在0.1秒到10秒内 | |||
| 点直径 | φ约3毫米 | |||
| 光源 | 卤素 | 氘和卤素混合 | 卤素 | 卤素 |
| 接口 | USB | |||
| 尺寸,重量 | <280(W)×570(D)×350(H)mm,约24kg | |||
| 软件 | ||||
| 标准 | 峰谷分析,FFT分析,优化方法分析,*小二乘分析 | |||
| 选项 | 材料评估软件,后期分析软件,膜模型分析,参考板 | |||
* 1请与我们联系以获取详细信息
* 2
超大规模集成电路薄膜厚度保证(100纳米二氧化硅/硅)* 3 所述的测量保证值范围对于VLSI薄膜厚度标准(100纳米二氧化硅/硅)重复测量的不确定性(包含因子2.1)
光学系统图

软件屏幕

相关产品











